这一篇继续聊半导体加工工艺,越来越多的人在接触半导体,也将有越来越多的人进入到这个行业,与这个行业打交道。
随着国家半导体行业的发展,从事制造业的人将或多或少进入到半导体行业,于是整理一些资料来聊一聊半导体加工工艺。
首先,如果大家手上有一颗芯片,要把这个芯片固定在电路板或其他基板上,实现芯片性能的正常输出,可以采用的方法有哪些?
最常见的方法有三种:
第一种是通过引线连接,采用导电性好的金丝将芯片管脚与电路相连接,称为wire bonding。
第二种是管脚贴合技术,将金丝转换成铜箔,铜箔与芯片管脚的凸点贴合,称为TAB。
第三种是倒装技术,是将芯片上导电的凸点与电路板上的凸点通过一定工艺连接起来,称为Flip chip。

由于半导体越来越集成化,体积越来越小,性能越来越高,于是倒焊技术越来越广泛的得到了应用。
这一篇,就来介绍一下芯片倒装技术。
芯片倒装的英文名称叫Flip Chip,就是让芯片的接触点与基板、载体、电路板相连,在相连的过程中,由于芯片的凸点是朝下连接,因此称为倒装。
倒装也是和普通元器件朝上放置相比较而言的,也称为DCA(Direct chip attach).
倒装芯片的示意图如下:
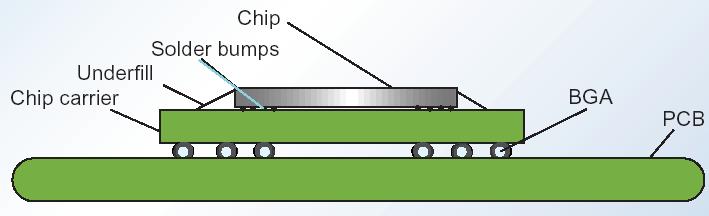
在典型的倒装芯片封装中, 芯片通过3到5个密耳(mil)厚的焊料凸点连接到芯片载体上,底部填充材料用来保护焊料凸点,上图中芯片Chip和PCB板通过倒装技术连接在一起。
日常中常见到了电子元器件很多都采用了倒装焊接技术,比如我们电脑中的内存条。

如果将内存条从截面剖开,芯片与电路板便是采用的倒装连接技术。

倒装芯片主要通过四个步骤完成:
第一步:凸点底部金属化 (UBM=under bump metallization)

凸点金属化是为了将半导体中P-N结的性能引出,其中热压倒装芯片连接最合适的凸点材料是金,凸点可以通过传统的电解镀金方法生成,或者采用钉头凸点方法,后者就是引线键合技术中常用的凸点形成工艺。
UBM的沉积方法主要有:
溅射:用溅射的方法一层一层地在硅片上沉积薄膜,然后通过照相平版技术形成UBM图样,然后刻蚀掉不是图样的部分。
蒸镀:利用掩模,通过蒸镀的方法在硅片上一层一层地沉积。这种选择性的沉积用的掩模可用于对应的凸点的形成之中。
化学镀:采用化学镀的方法在Al焊盘上选择性地镀Ni。常常用锌酸盐工艺对Al表面进行处理。无需真空及图样刻蚀设备,低成本。

这部分是形成凸点,可以看做给P-N结做电极,类似于给电池加工一个输出端。
常见的6种形成凸点形成办法:
- 蒸镀焊料凸点,
- 电镀焊料凸点,
- 印刷焊料凸点,
- 钉头焊料凸点
- 放球凸点
- 焊料转移凸点
以典型的电镀焊料凸点来看,其加工示意图如下:

完成后的凸点在扫描电子显微镜下观察,微观形态是一个体型均匀的金属球。

下图是凸点形成前后的对比,回流加热前为圆柱体,加热后金属材料融化,形成球形融化电极。

第三步:将已经凸点的晶片组装到基板/板卡上
在热压连接工艺中,芯片的凸点是通过加热、加压的方法连接到基板的焊盘上。该工艺要求芯片或者基板上的凸点为金凸点,同时还要有一个可与凸点连接的表面,如金或铝。对于金凸点,一般连接温度在300℃左右,这样才能使材料充分软化,同时促进连接过程中的扩散作用。

第四步:使用非导电材料填充芯片底部孔隙
填充时,将倒装芯片与基板加热到70至75℃,利用装有填料的L形注射器,沿着芯片的边缘双向注射填料。由于缝隙的毛细管的虹吸作用,填料被吸入,并向中心流动。芯片边缘有阻挡物,以防止流出。有的使用基板倾斜的方法以利于流动。
填充完毕后,在烘箱中分段升温,达到130 ℃左右的固化温度后,保持3到4小时即可达完全固化。
下面是填胶示意图:

填胶完成后的芯片和基板稳定的结合在一起,完成后的示意图:

经过以上的四步工序,完成了芯片与基体的倒装连接,虽然介绍起来并不复杂,但要完整完成这几部工序依然是件系统的工程!
关于芯片倒装技术先介绍这么多吧,下次再聊!
,




